摘要:對 IGBT 模塊的熱特性和熱設計進行概述,介紹 IGBT 模塊的熱阻抗網(wǎng)絡模型及其與封裝材料熱性能及尺寸的關系;從芯片和模塊封裝材料?結(jié)構(gòu)等方面討論模塊的熱設計要點,并闡述傳統(tǒng) IGBT 模塊及新型壓接式 IGBT 模塊的熱設計?
關鍵詞:半導體;IGBT 模塊;熱設計;可靠性;散熱解決方案
引言
大功率半導體器件是實現(xiàn)能量產(chǎn)生?傳輸?轉(zhuǎn)換和控制的單元,是功率電子系統(tǒng)的最核心部件,在很大程度上決定了功率系統(tǒng)的性能?效率?可靠性?成本?體積和重量?目前,600 V及以上的大功率半導體器件領域,主流產(chǎn)品是硅基絕緣柵雙極晶體管(insulated gate bipolar transistor,IGBT)和對應的續(xù)流二極管(freewheeling diode,FWD)?功率半導體器件的基本單元是芯片,基于成品率?一致性和可制造性等方面的原因,IGBT 芯片的尺寸一般小于 200 mm2,電流最大可達 300 A 左右?為了滿足大功率系統(tǒng)的需求,一般將 IGBT 和 FWD 芯片并聯(lián)封裝成 IGBT 模塊結(jié)構(gòu)?IGBT 模塊除實現(xiàn)芯片之間的電學互連?動單元及外部主電路的連接之外,還起到支撐?保護?散熱等作用?
作為大功率半導體器件的應用單元,IGBT 模塊的封裝形式?結(jié)構(gòu)?技術和材料在很大程度上決定了模塊的整體性能和可靠性?因此,IGBT 模塊的封裝技術對產(chǎn)業(yè)界和用戶具有至關重要的意義,IGBT 模塊的設計?制造?測試及可靠性一直是功率半導體研發(fā)的重點課題之一?
IGBT 等功率半導體器件不是理想的開關元件,在導通狀態(tài),芯片本身有一定電阻,產(chǎn)生通態(tài)損耗;在開關過程中,由于時間延遲,形成電壓和電流的重疊,產(chǎn)生開關損耗?功率損耗引起芯片結(jié)溫( Tj)上升,當超過允許的最高結(jié)溫(Tjmax)時將產(chǎn)生熱失效?因此,必須將損耗產(chǎn)生的熱量快速高效地發(fā)出去,以降低高 Tj 對芯片的損害,提高芯片的可靠性和壽命?
IGBT 模塊的熱設計是通過結(jié)構(gòu)?材料和封裝技術等設計,降低芯片到殼體(基板)的熱阻(Rth j-c)及熱時間常數(shù)(τ),實現(xiàn)快速高效地器件產(chǎn)生的熱量散發(fā)到殼體?此外,在實際應用中,還需要通過系統(tǒng)的熱管理技術將到達模塊殼體的熱流有效地散發(fā)到外部散熱器或冷卻系統(tǒng)中?
本文主要概述傳統(tǒng) IGBT 模塊的熱行為和熱設計,以及新型壓接式 IGBT 模塊的熱設計方法?通過 IGBT 模塊的熱阻抗網(wǎng)絡模型,論述熱阻與封裝材料熱性能及尺寸的關系?討論功率半導體器件的功率損耗對結(jié)溫?溫度變化對模塊壽命的影響?并從芯片和模塊封裝結(jié)構(gòu)?材料等方面分析模塊的熱設計要點,以及 IGBT 模塊在應用系統(tǒng)中的熱管理方案?
1 IGBT 模塊的熱阻網(wǎng)絡
傳統(tǒng) IGBT 模塊的結(jié)構(gòu)剖面圖如圖 1 所示,通過陶瓷襯板實現(xiàn)芯片與外部的絕緣,基板起到散熱?支撐及與外部散熱器接觸的作用,通過鋁引線鍵合?焊料層實現(xiàn)電學互連和連接?
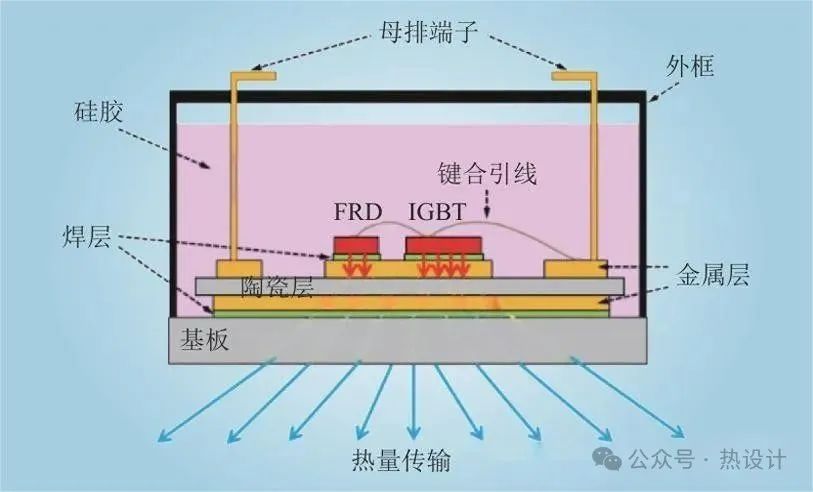
圖 1 傳統(tǒng) IGBT 模塊結(jié)構(gòu)剖面圖
其中模塊的鋁鍵合引線與芯片的鍵合點較小,芯片工作中產(chǎn)生的熱量主要通過熱傳導的方式由芯片向基板單向傳遞,在此過程中會遇到一定的阻力,稱為導熱熱阻?芯片到殼體的熱阻 Rth j-c是散熱路徑上各層材料熱阻的串聯(lián)之和?根據(jù)式(1),每一層材料的熱阻和熱容由其散熱面積及厚度決定,散熱面積由材料的熱擴散角 α 決定?

式中:Rth 為材料導熱熱阻;d為導熱介質(zhì)層厚度;k 為熱導率;A 為導熱介質(zhì)面積;C 為熱容;c 為材料比熱容;m 為材料質(zhì)量?在 IGBT 模塊的散熱路徑上,由芯片向下,散熱面積 A 逐漸增大,假設散熱角 α 恒定,導熱區(qū)域為正方形,見圖 2,則第 i 層導熱介質(zhì)面積 Ai 近似由式(2)估算?

式中:di 為第 i 層介質(zhì)厚度;li−1 為 i–1 層導熱介質(zhì)邊長?
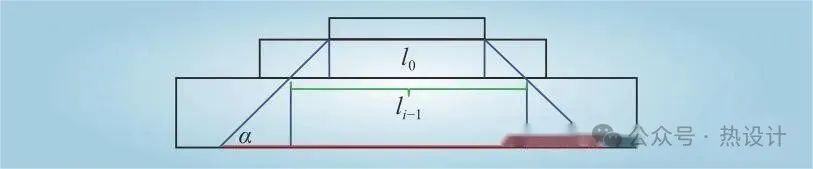
圖 2 IGBT 模塊散熱路徑上不同介質(zhì)的散熱面積
根據(jù) Cauer 模型,傳統(tǒng) IGBT 模塊的等效熱阻網(wǎng)絡見圖 3?該模型基于實際物理意義,將整體熱阻等效為各層導熱介質(zhì)的熱阻之和,各介質(zhì)的熱容由其材料屬性和質(zhì)量決定?根據(jù)此模型,IGBT 模塊的 Rth j-c 可以通過計算得到?

圖 3 IGBT 模塊等效熱阻網(wǎng)絡 Cauer 模型
2 IGBT 模塊的熱設計和熱管理
IGBT 模塊的 Rth j-c 與芯片面積有直接關系,芯片面積越大,散熱通道的截面積越大,Rth j-c 越小?然而,為了提升模塊及功率系統(tǒng)的功率密度,減小體積,目前的研發(fā)重點是逐漸增加芯片的電流密度,減小芯片的整體面積,從而增加了Rth j-c?采用薄片工藝,可以在一定程度上降低芯片功耗和 Rth j-c?在 IGBT 模塊的設計中,需要通過優(yōu)化結(jié)構(gòu)和材料,降低高功率密度芯片引起的熱阻增加?并通過提高芯片的 Tjmax,增加熱設計的余量和模塊的可靠性?
2.1 封裝材料對熱特性的影響
除半導體芯片外,傳統(tǒng) IGBT 模塊的封裝材料主要包括絕緣襯板?母排端子?鍵合引線?焊料?基板?硅膠?塑料外殼等?材料熱設計的關鍵是選擇導熱率高?CTE 匹配率高的材料組合,從而降低熱阻,減小熱-機械應力?熱-機械應力是功率模塊熱疲勞退化和失效的主要原因,它是在溫度變化過程中由材料的 CTE 不同引起的,對模塊的結(jié)合層和互連部分影響最大?因此,基于熱特性優(yōu)化選擇模塊材料是提升模塊熱穩(wěn)定性和壽命的重要環(huán)節(jié)?
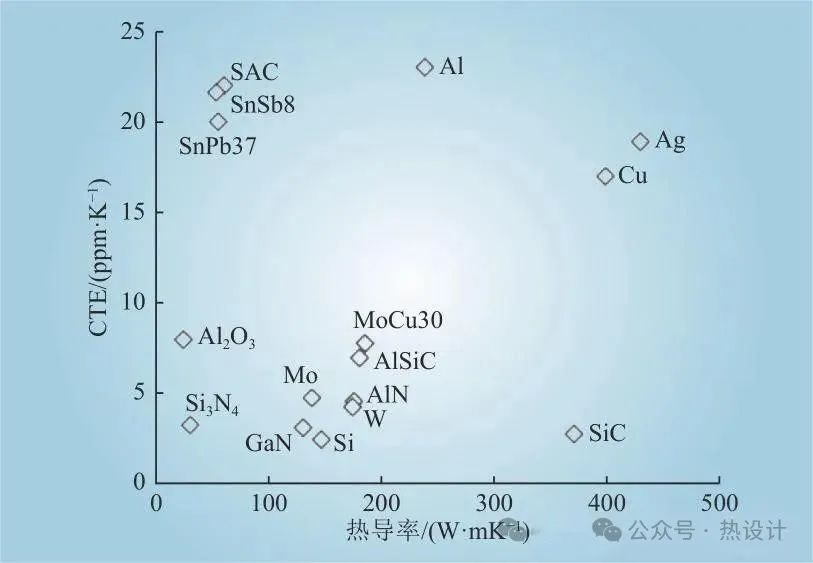
圖 4 IGBT 模塊常用封裝材料的熱特性
圖 4 為 IGBT 模塊常用封裝材料的主要熱學參數(shù)?目前常用的絕緣襯板主要有Al2O3?AlN?Si3N4 等,就熱特性來說,AlN 是比較理想的封裝材料,也是大部分IGBT模塊的首要選擇?但Al2O3 具有成本上的優(yōu)勢,Si3N4 具有機械強度方面的優(yōu)勢,在設計中需要根據(jù)應用需求作具體考慮?IGBT 模塊常用的芯片互連材料是 Al 鍵合引線,但其導熱?導電性都比 Cu 材料弱,而且 CTE比 Cu 大,在溫度沖擊中,所受熱-機械應力更大,可靠性較低?因此,銅線鍵合具有電學?熱學?可靠性等方面的優(yōu)勢,是功率模塊封裝材料和技術的發(fā)展趨勢?
目前,IGBT模塊的基板材料主要有Cu?AlSiC以及Cu合金等?Cu材料具有高熱導率,但CTE 與 Si?襯板等材料相差較大,工作中易產(chǎn)生大的熱-機械應力?AlSiC 與模塊系統(tǒng)其他材料的 CTE 匹配度更高,熱導率相對較高,是高可靠性模塊常選的封裝材料?
對硅膠和外殼等灌封材料來說,工作溫度范圍和熱穩(wěn)定性是需要重點考慮的參數(shù),一般通過高低溫存儲和沖擊試驗進行檢測,尤其對于應用在嚴苛溫度條件下的功率模塊,溫度特性和穩(wěn)定性是模塊灌封材料的重要考核指標?
2.2 模塊結(jié)構(gòu)的熱設計方案
IGBT 模塊的結(jié)構(gòu)在一定程度上決定了其熱阻的大小,圖 3 是基于傳統(tǒng) IGBT 模塊結(jié)構(gòu)的等效熱阻網(wǎng)絡,表征 Rth j-c 由模塊結(jié)構(gòu)的散熱路徑?jīng)Q定?在應用中,傳播到模塊殼體的熱量將由外部散熱器帶走,因此由模塊到散熱器的熱阻 Rth c-h 是模塊熱設計和熱管理的重要一環(huán)?由芯片到外部散熱器的熱阻 Rth j-h 可以表示為

在應用中,傳統(tǒng)模塊的平面基板殼體與散熱器之間一般施加 0.1 mm 左右厚的導熱硅脂,用以填充基板與散熱器接觸時的空隙,增加散熱效率?由于導熱硅脂的熱導率較低,一般 Rth c-h 占到整體熱阻 Rth j-h 的 50% 左右?通過模塊封裝結(jié)構(gòu)設計,如直接散熱,應用中可以去除導熱硅脂層,大幅度降低整體熱阻?
2.2.1 直接水冷散熱結(jié)構(gòu)
圖 5 為直接液體冷卻( direct liquid cooled: DLC) IGBT模塊結(jié)構(gòu)示意圖?采用針翅( Pin Fin)結(jié)構(gòu)基板,應用中不需導熱硅脂層和外部散熱器而實現(xiàn)直接液體冷卻,與傳統(tǒng)平面基板結(jié)構(gòu)比,Rth j-h 降低一半左右,見圖 6?
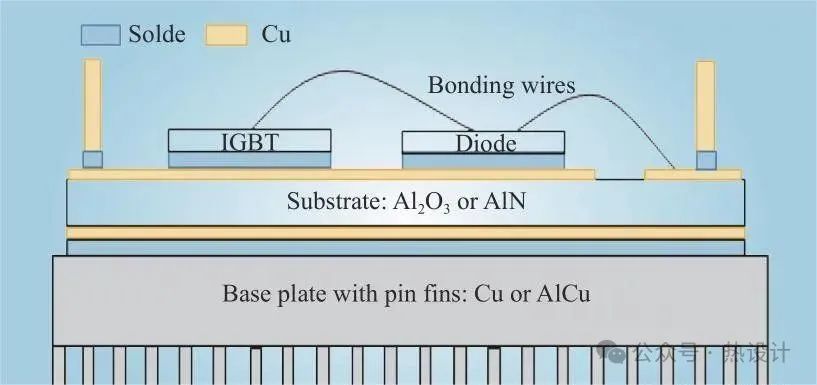
圖 5 DLC IGBT 模塊結(jié)構(gòu)

圖 6 DLC 與傳統(tǒng)結(jié)構(gòu) IGBT 模塊熱阻比較
2.2.2 平面封裝雙面散熱結(jié)構(gòu)
平面封裝結(jié)構(gòu)采用金屬層替代芯片表面的鋁鍵合引線互連,可以降低電學寄生參數(shù),提高載流能力,具有電學?熱學?機械及可靠性方面的一系列優(yōu)點?
通過平面封裝結(jié)構(gòu)和技術,可以將 IGBT 模塊產(chǎn)生的熱量損耗通過上?下兩個方向的散熱器擴散,達到雙面冷卻(double sided cooling,DSC)的效果?Rth j-c DSC 結(jié)構(gòu)的結(jié)殼等效熱阻計算公式如式(4)所示,其中 Rth j-c T?Rth j-c B 分別為芯片到殼體上?下表面的熱阻?采用對稱設計,可以將模塊的散熱效率提高一倍,等效 Rth j-c 降低一半左右,從而大大降低 Tj,提高熱性能和溫度可靠性?

圖 7 為株洲中車時代電氣最新開發(fā)的 DSC 平面封裝汽車 IGBT 模塊的結(jié)構(gòu)示意圖?功率芯片通過焊接或銀燒結(jié)技術與兩層絕緣襯板相連,電流通道經(jīng)過上層襯板的覆銅層?芯片產(chǎn)生的熱量通過兩層襯板擴散到外部散熱器?模塊外殼通過轉(zhuǎn)模技術形成,具有較高的工作溫度和可靠性?
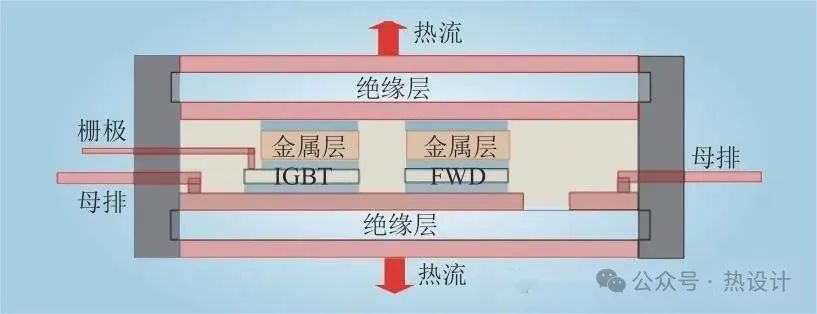
圖 7 平面封裝 DSC IGBT 模塊結(jié)構(gòu)
DSC 模塊沒有基板,其 Rth j-h 比 DLC 模塊的低 50% 以上?但由于沒有集成直接水冷散熱器,應用中需要通過導熱材料或焊接與外部散熱器接觸,從而增加了 Rth j-h?圖 8 為 DSC 模塊在不同安裝方式下的等效 Rth j-h 及其與 DLC 模塊的比較?通過導熱材料壓接安裝的 DSC 模塊,其 Rth j-h 比DLC 模塊減小 30% 左右,此數(shù)值受導熱材料的熱導率影響;通過焊接安裝的 DSC 模塊的 Rth j-h比DLC 結(jié)構(gòu)的減小 40% 左右?

圖 8 DSC 模塊 Rth j-h 及其與 DLC 模塊比較
2.2.3 集成相變結(jié)構(gòu)散熱結(jié)構(gòu)
相變散熱通過相變材料的物質(zhì)狀態(tài)改變吸收熱量,如液體蒸發(fā)成氣體的過程?熱管或蒸汽腔室就是利用液體相變過程實現(xiàn)散熱的結(jié)構(gòu),具有較高的散熱效率,在功率半導體器件和系統(tǒng)的熱管理中已經(jīng)應用?但該結(jié)構(gòu)一般作為外部散熱設計,應用在功率模塊之外?當把熱管或蒸汽腔室結(jié)構(gòu)集成在模塊封裝之內(nèi)時,將實現(xiàn)高效率散熱和緊湊封裝?
圖 9 為基板集成相變散熱( phase change cooling,PCC)結(jié)構(gòu)的 IGBT 模塊剖面圖?模擬結(jié)果表明,與傳統(tǒng)結(jié)構(gòu)相比,該集成相變結(jié)構(gòu)能夠降低熱阻 15% 左右?中車時代電氣根據(jù)此設計試制出了一款電動汽車級功率模塊,見圖 10?
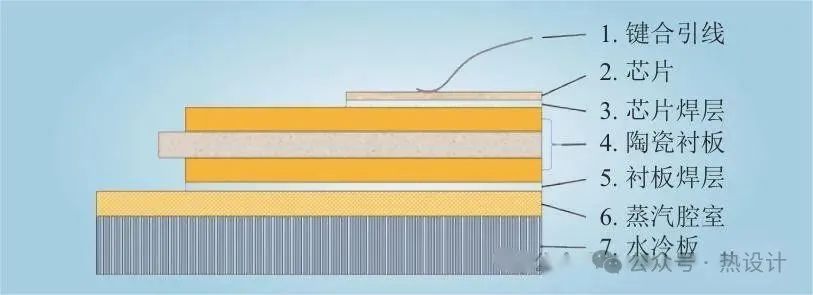
圖 9 基板集成相變散熱結(jié)構(gòu) IGBT 模塊

圖 10 集成相變散熱結(jié)構(gòu) IGBT 模塊樣品
其他模塊結(jié)構(gòu)方面的熱設計還包括無基板結(jié)構(gòu)?無襯板結(jié)構(gòu)如直接芯片鍵合到母排(die on leadframe,DOL)?襯板直接液體冷卻?襯板基板一體化設計?集成液體循環(huán)冷卻通道等?其設計目標是通過簡化模塊結(jié)構(gòu),減少結(jié)合層,去除熱界面材料(thermal interface material,TIM),實現(xiàn)降低熱阻抗,降低 Tj,增加熱穩(wěn)定性和可靠性?
在模塊封裝工藝方面,先進的結(jié)合和互連技術可以大幅度提升模塊的熱穩(wěn)定性?開發(fā)更高熱導率的焊接?燒結(jié)和引線材料,或采用大面積金屬片替代引線鍵合技術,如直接端子鍵合(direct lead bonding,DLB),可以增加通流及導熱能力,實現(xiàn)溫度均勻分布,減少過熱點?采用超聲鍵合技術(ultrasonic welding)進行端子連接,去除端子與襯板的結(jié)合層,可以大幅降低熱-機械應力,提升熱穩(wěn)定性?
2.3 不同封裝結(jié)構(gòu)的熱阻比較
對不同散熱結(jié)構(gòu)的 IGBT 模塊,測試了結(jié)-冷卻液熱阻(Rth j-f),如圖 11 所示?在以上 3 種結(jié)構(gòu)中,DSC 模塊的散熱效率最高,熱阻最低,是下一代高功率密度 IGBT 模塊的發(fā)展趨勢?試驗結(jié)果驗證了 PCC 結(jié)構(gòu)的散熱效率比 DLC 結(jié)構(gòu)高15% 左右,在一定程度和范圍內(nèi)具有較好的應用前景?然而,在今后一段時期,由于 DLC 模塊具有制造過程和應用簡單的優(yōu)勢,依然是高性能高可靠性 IGBT 模塊如電動汽車等應用領域的主流產(chǎn)品?
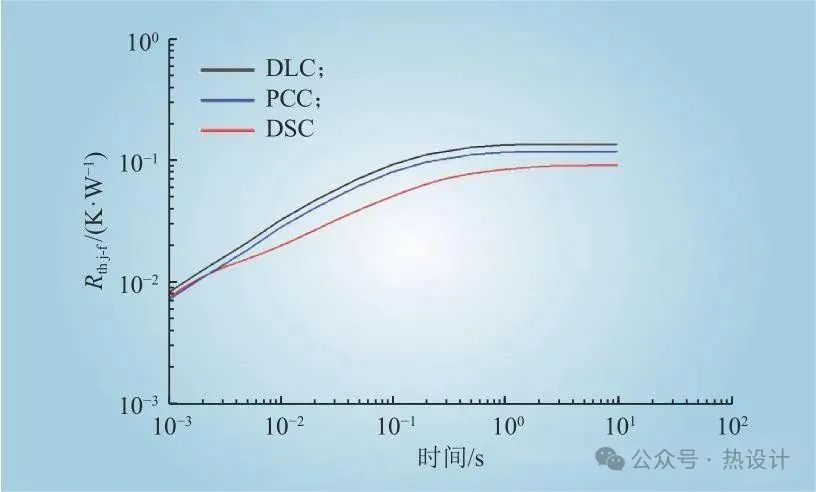
圖 11 不同散熱結(jié)構(gòu) IGBT 模塊的熱阻比較
2.4 壓接式 IGBT 模塊熱設計
壓接式 IGBT(press pack IGBT,PPI)模塊是特高壓柔性直流輸電系統(tǒng)的理想開關器件,其全控可關斷能力是系統(tǒng)電壓源換流器的最關鍵需?目前的新建特高壓直流輸電項目,已經(jīng)進入IGBT 模塊取代大功率晶閘管的階段,如近期完成系統(tǒng)試驗的張北和烏東德工程,分別部分和全部采用了 PPI 模塊,實現(xiàn)了世界電壓等級最高和輸送容量最大的柔性直流輸電能力?
PPI 模塊的封裝概念和結(jié)構(gòu)來源于大功率晶閘管,大面積的功率端子通過壓力與多個芯片的正面和背面接觸,進行芯片互連,形成并聯(lián),從而提升功率能力?通過設計,壓接式封裝結(jié)構(gòu)能夠?qū)崿F(xiàn)雙面散熱?失效短路等目標,這是高壓直流輸電系統(tǒng)等需要通過串聯(lián)多個功率器件實現(xiàn)高壓的系統(tǒng)的關鍵要求?而傳統(tǒng)焊接型 IGBT 模塊的非平面互連結(jié)構(gòu),在功率能力?散熱?短路失效?可靠性等方面都不如 PPI 模塊?
圖 12 為中車時代電氣 PPI 模塊產(chǎn)品的基本結(jié)構(gòu)單元和模塊結(jié)構(gòu)剖面圖?其基本單元由芯片?金屬間隔片?柵極連接針以及絕緣框架組成,通過模塊級封裝,將多個基本單元并聯(lián)封裝在模塊之中,其主要部件包括陶瓷管殼?管蓋?管座?柵極回路 PCB 等?因此,PPI 模塊的熱設計包括基本單元級和模塊級兩方面?
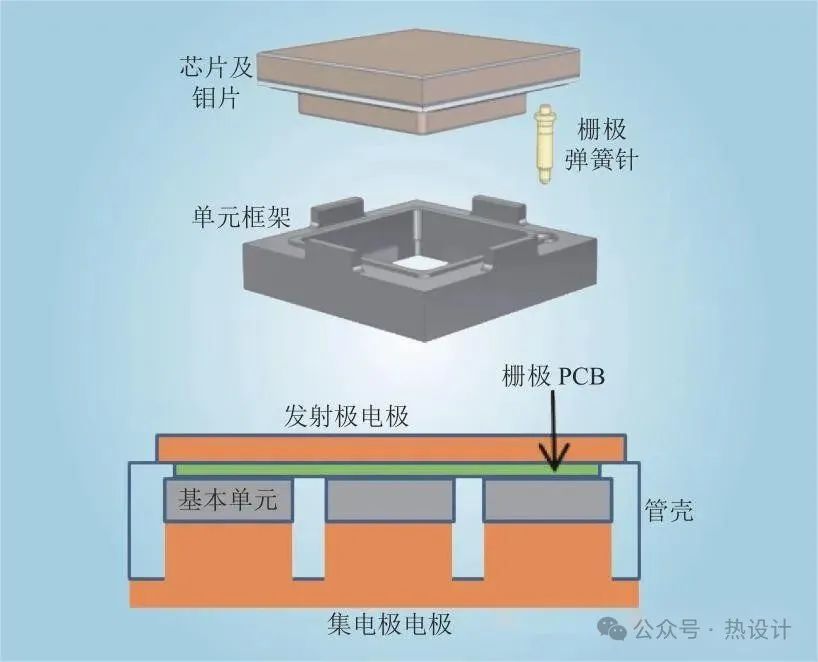
圖 12 PPI 模塊基本結(jié)構(gòu)單元和整體結(jié)構(gòu)剖面圖
根據(jù) PPI 模塊中使用的材料?尺寸?工藝和應用工況等信息,可以建立精準的熱學仿真模型,將這些信息以合理的方式在熱模型中表征出來,輸出如圖 13 顯示的溫場分布,以進行 PPI 模塊的熱管理設計和優(yōu)化?圖 14 為 PPI 模塊在不同壓力下的瞬態(tài)熱阻抗曲線,隨著壓裝力的增加,器件的接觸熱阻減小,整體熱阻降低,且熱阻變化量也在減小,根據(jù)其變化規(guī)律可以實現(xiàn)壓裝力范圍的標定?
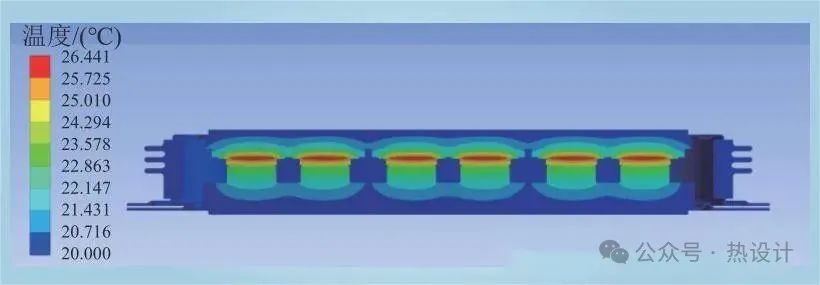
圖 13 應用工況下 PPI 模塊的溫度分布云圖

圖 14 PPI 模塊在不同壓力下的瞬態(tài)熱阻抗曲線
3 結(jié)語
IGBT 模塊的熱性能和熱穩(wěn)定性是模塊設計?表征和應用評估的重要方面?實現(xiàn)快速?高效地對芯片進行冷卻降溫是封裝和應用設計關鍵,將大大提升 IGBT 模塊的性能,降低芯片結(jié)溫和功率損耗,從而提高穩(wěn)定性和可靠性?尤其是隨著IGBT 模塊功率密度的增加?應用環(huán)境的惡劣?可靠性和壽命的要求提高,IGBT 模塊的熱設計和熱管理技術是新型產(chǎn)品設計和應用的最重要環(huán)節(jié)?
本文主要概述了傳統(tǒng) IGBT 模塊的熱行為及熱設計技術,以及面向柔性直流輸電電網(wǎng)應用的壓接式 IGBT 模塊的熱設計?基于 IGBT 模塊的熱阻抗網(wǎng)絡模型,從封裝材料?結(jié)構(gòu)和工藝技術等方面論述了 IGBT 模塊熱設計和熱管理方案?通過新型高熱性能材料的組合,集成化封裝結(jié)構(gòu)和高溫度穩(wěn)定性封裝技術,可以實現(xiàn) IGBT 模塊的熱性能?可靠性和壽命的增強和提升?
注:熱設計尊重原創(chuàng),轉(zhuǎn)載文章的版權歸原作者所有,如有侵權,請聯(lián)系刪除?





